【2025年英特尔代工大会(Intel Foundry Direct Connect)于今日开幕】,英特尔公布了在核心制程技术、先进封装和全球生态布局方面的最新成果,同时宣布了多项全新合作计划。来自业界的重要合作伙伴、生态企业及客户高管共同探讨了英特尔系统级代工战略的发展,以及其在加速创新和推动协同合作中的作用。
英特尔首席执行官陈立武(Lip-Bu Tan)在大会致辞中表示,英特尔代工业务正进入全新阶段,公司将坚持以客户为中心,深化先进制程与封装技术,构建全球领先的制造与生态系统。代工首席技术与运营官 Naga Chandrasekaran 与代工服务总经理 Kevin O’Buckley 也分别发表演讲,聚焦 Intel 18A/14A 工艺的进展、全球产能布局与技术演进。
陈立武强调:“我们正在全公司范围内推进‘工程至上’文化,倾听客户声音,以赢得信任。通过不断强化与生态伙伴的合作,英特尔将在全球代工领域取得持续突破。”
多代制程路线图曝光:14A 搭载 PowerDirect,18A-P/18A-PT 强化性能与封装
在制程方面,英特尔宣布 Intel 18A 工艺已进入“风险试产”阶段,并计划年内实现正式量产。该工艺采用 PowerVia 背面供电技术,并已获得 EDA 工具、IP 及流程支持。18A 的性能增强版本 Intel 18A-P 也已开始试验晶圆流片,其设计规则与 18A 完全兼容,便于客户迁移设计。
进一步延伸的 Intel 18A-PT 将支持英特尔自研 Foveros Direct 3D 封装技术,互连间距缩小至 5 微米以内,为高性能、高密度芯片堆叠提供可能。
与此同时,Intel 14A 节点也正与客户展开合作,相关 PDK 工具已发放,客户正基于其 PowerDirect 供电架构测试芯片原型。
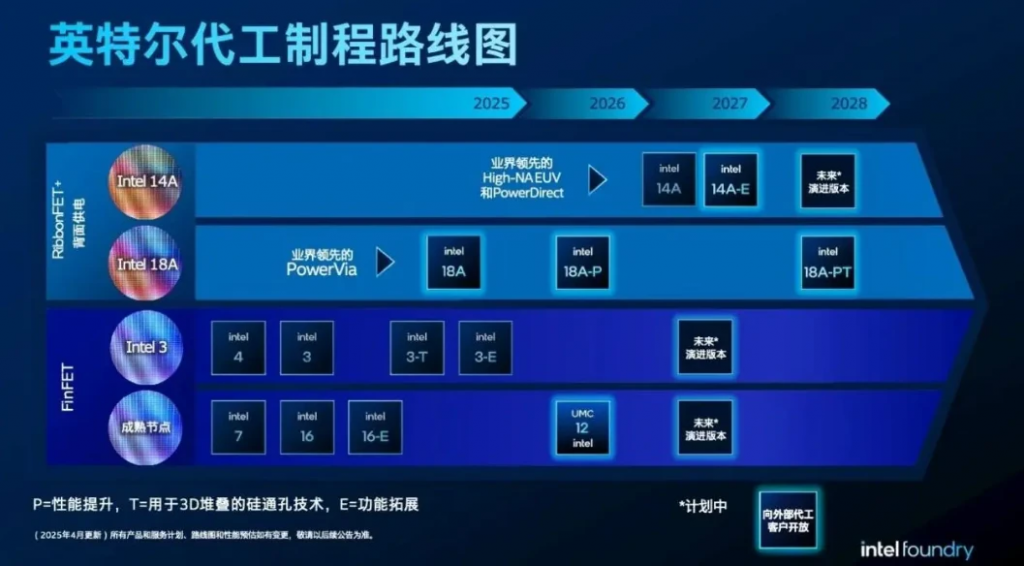
先进封装拓展:Foveros-R、EMIB-T 等新技术亮相
在封装领域,英特尔加速部署系统级封装解决方案。利用 Intel 14A 和 18A-P 工艺,客户可通过 Foveros Direct(3D堆叠)与 EMIB(2.5D桥接)实现高带宽连接。
此次大会还首度亮相多种新封装技术:
-
EMIB-T:面向下一代高带宽内存应用
-
Foveros-R / Foveros-B:为客户提供更灵活高效的3D封装选择
英特尔同时宣布与 Amkor Technology 建立合作,扩展封装技术服务范围,满足不同客户定制化封装需求。
制造产能稳步扩展:18A 制程将在俄勒冈率先量产
制造方面,亚利桑那州 Fab 52 工厂已完成首批 Intel 18A 芯片流片,展示了量产前的制造准备成果。Intel 18A 的大规模量产将首先在俄勒冈州实现,亚利桑那州工厂则将在年内启动量产爬坡。
此外,首批基于 16nm 工艺的代工产品也已投入晶圆厂生产,英特尔与联华电子(UMC)联合开发的 12nm 工艺也已进入客户合作阶段。
生态系统持续扩张:新增芯粒联盟与价值链联盟
为加快代工生态布局,英特尔代工加速联盟(Intel Foundry Accelerator Alliance)新增多个子项目:
-
Intel Foundry Chiplet Alliance(芯粒联盟):推动模块化设计标准化,满足特定市场需求
-
Value Chain Alliance(价值链联盟):整合 IP、EDA、封装和系统设计资源,形成完整支持链条
合作伙伴包括 Synopsys、Cadence、Siemens EDA、PDF Solutions 等,涵盖设计、验证、封装、测试等多个关键环节。
微软、高通、联发科等客户高管也出席大会并参与讨论,进一步彰显英特尔代工生态体系的开放性与影响力。
1 修改版本安卓及电脑软件,加群提示为修改者自留,非本站信息,注意鉴别;
2 本网站部分资源来源于网络,仅供大家学习与参考,请于下载后24小时内删除;
3 若作商业用途,请联系原作者授权,若本站侵犯了您的权益请联系站长进行删除处理;
4 如果您喜欢该内容,请支持正版,购买注册,得到更好的正版服务。
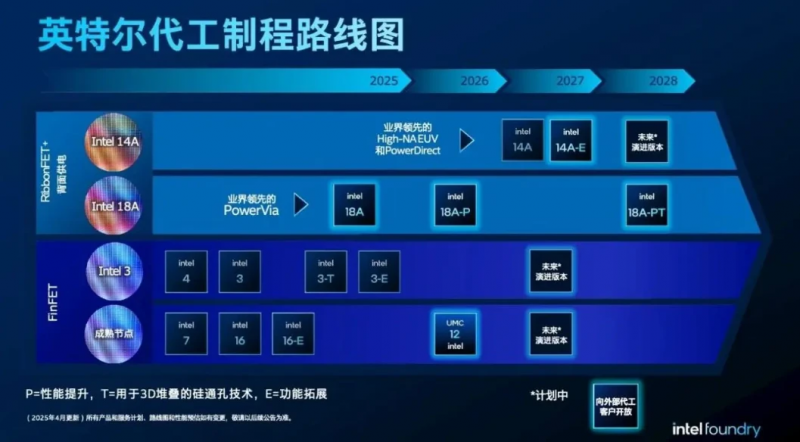















暂无评论内容